歩留まり管理は、半導体製造において重要な要素です。歩留まりを改善する上で、1つの重要な技術は、不良チップまたはウェハーの剥離処理です。そして不良部分を見つけ分析して不良を無くすことが何よりも重要なポイントになります。
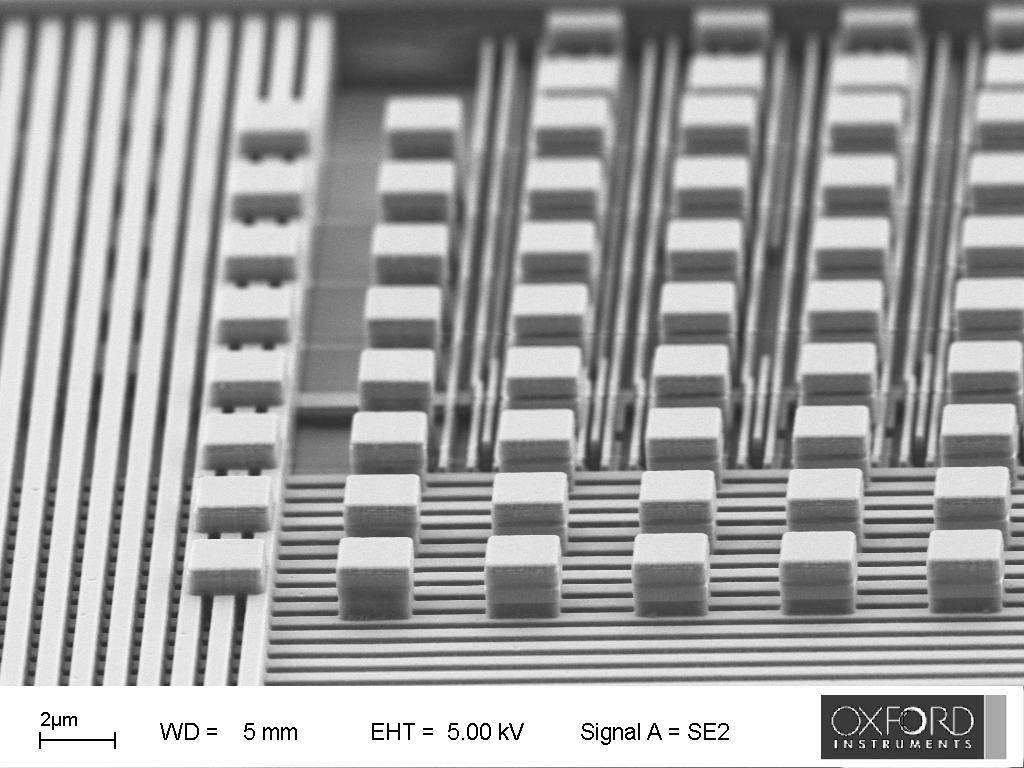
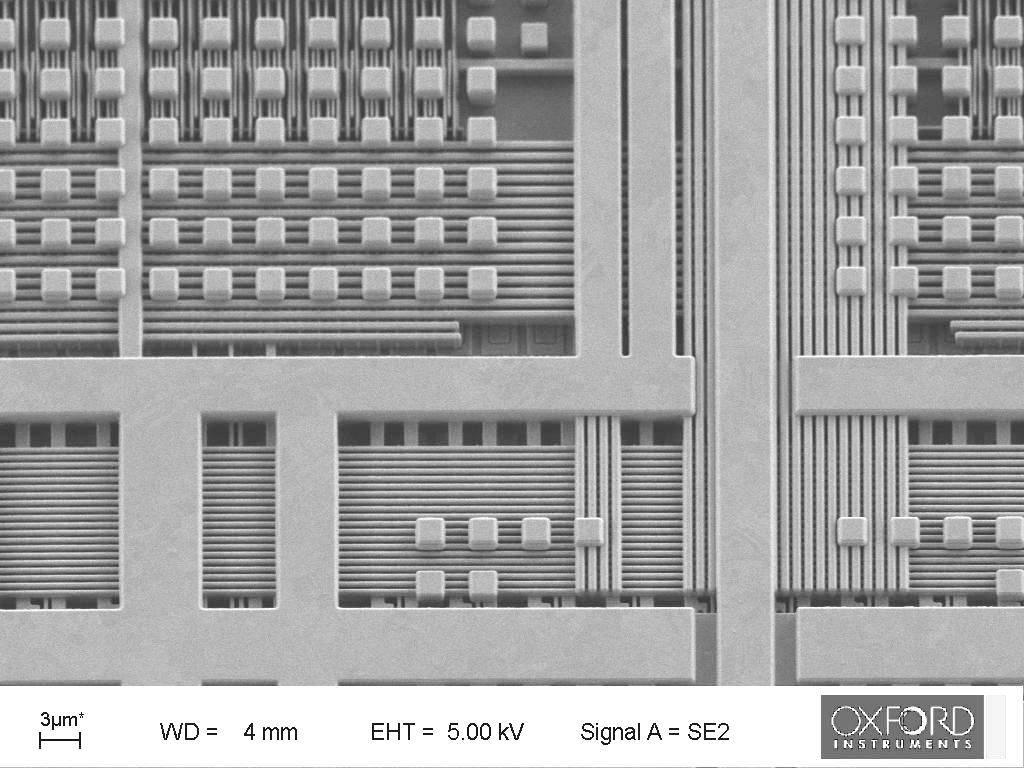
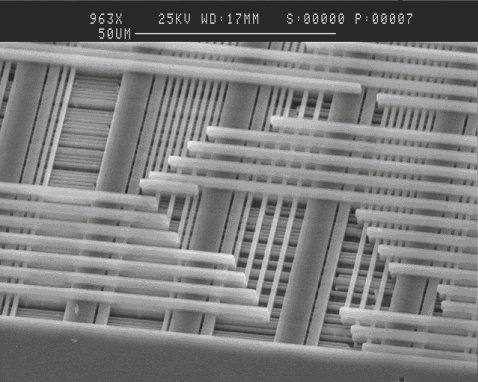

故障解析や欠陥特定を行うには、デバイスは適切に準備されなければなりませんが、デバイス設計が一段と3次元構造になっているため、難しい課題になっています。正確かつ迅速な結果を確実に出すために、プラズマにより強化されたエッチングとデポジションが使われています。
オックスフォード・インストゥルメンツの柔軟な故障解析(FA)ツールにより、広範なプロセスにおいて、小さなダイまたはパッケージのデバイスから300mmウェハまで、処理することができます。良く制御された処理により、金属の電導トラックにおける損傷を防止します。