2026年度オックスフォード・インストゥルメンツの予算申請用カタログが完成しました。目的やご予算に応じた最適な機器をスムーズに比較・検討いただけます。予算の検討・次期設備導入のご検討に、ぜひご活用ください。
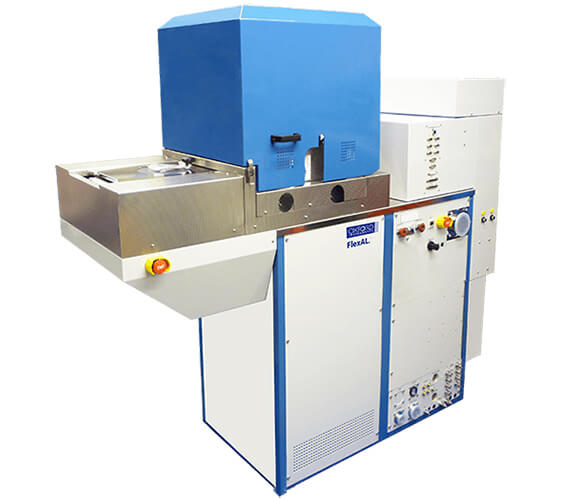
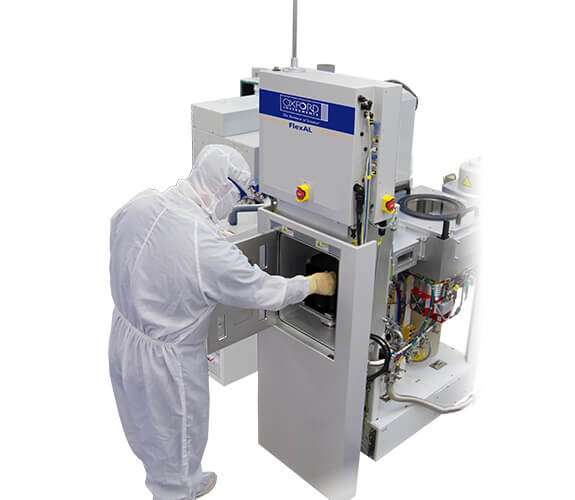



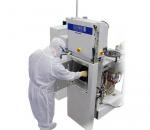


FlexAL ALD (原子層堆積) システムは、最適化された高品質のプラズマALDおよび熱ALDプロセスを幅広く提供し、一つのプロセスチャンバーを用いたプリカーサー、プロセスガス、ハードウェア構成に高い柔軟性を備えています。
一つのデポジションチャンバー内で熱ALDと、リモートプラズマによる低ダメージのプラズマALDの併用が可能
薄膜特性をコントロールするRF電極オプション
製造プロセスに最適なカセット方式のハンドリングにより、高いスループットが実現
プリカーサー、プロセスガス、ハードウェア、オプションの選択にも、高い柔軟性
低ダメージで高品質な 基板を維持するために最適化
交換可能なライナーにより、チャンバーのメンテナンスが容易
温度変化の影響が大きい表面に対しても、高品質な薄膜を実現する低温デポジション
当社の ALD シリーズでは、学術界、企業の研究開発、小規模生産の様々な要求を満たすための様々なツールを用意しています。オックスフォード・インストゥルメンツは、豊富なプロセスライブラリを有しており、新しいプロセスも継続的に開発されています。当社は、ALD 装置の使用期間中、無料で継続的なプロセスサポートを提供し、新しい材料の開発に関するアドバイスや、新しいプロセスレシピを含む当社の最新の ALD プロセス開発への継続的な提供を行っています。
プラズマ ALD プロセスにおいて、イオンは重要な役割を果たします。イオンは、特に窒化物や低い成膜温度で膜質を向上させることができます。しかし、ある種の界面や基板は、イオンの影響を受けやすく、デバイスのダメージにつながる可能性があります。FlexAL ALD システムは、先進のプラズマ源と自動マッチングユニット(AMU)によってプラズマイオンを正確に制御し、ダメージを最小限に抑えながら、プラズマのメリットを最大限に生かすことができます。
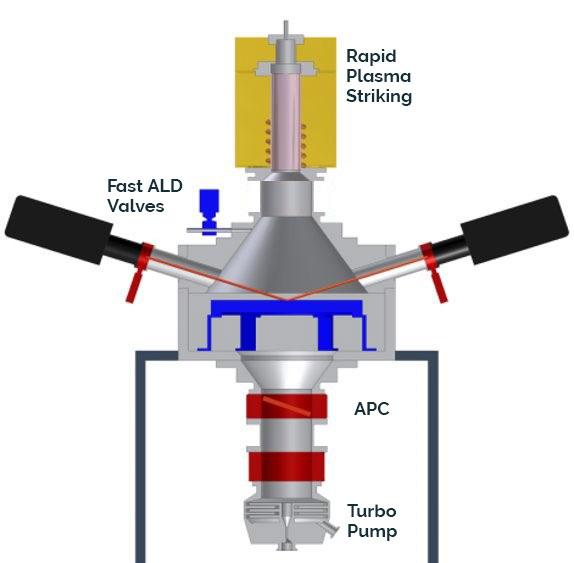

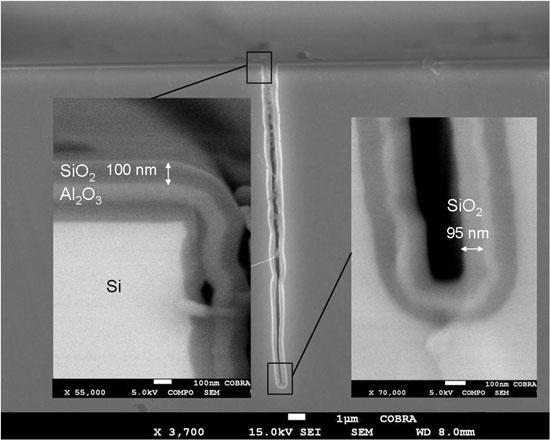
画像:高コンフォーマルプラズマ ALD Al2O3 (左図)、 SiO2 (右図) - 提供 アイントホーフェン工科大学
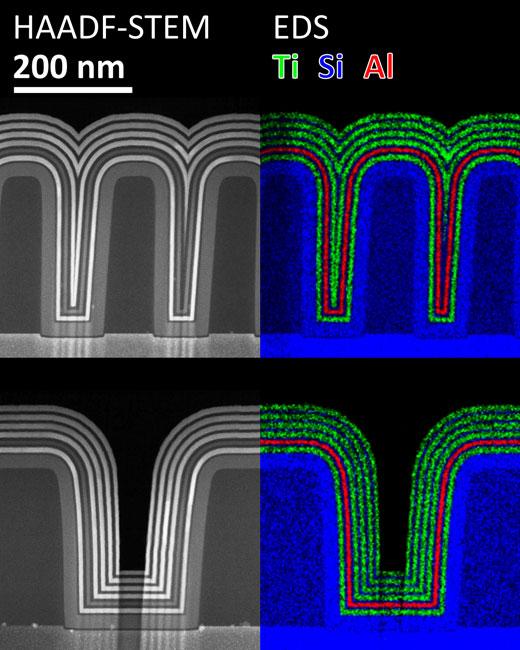
画像:プラズマ ALD を用いた SiO2、TiO2、Al2O3 のコンフォーマルデポジション, (CC BY 4.0 license), image library at www.AtomicLimits.com, 2021
ウェハサイズ: 最大 200 mm
プラズマ源発生装置:300 W または 600 W
温度範囲:30 ~ 550 °C (テーブルバイアス使用)
プリカーサ
クラスター化可能モジュール:PECVD、ICPCVD、RIE、スパッタリングモジュール
当社のプラズマテクノロジーとアイントホーフェン工科大学は、15年にわたるパートナーシップのもと、ナノ加工技術の多くのアプリケーションにおいて、最も急速に発展している技術の 1 つである ALD (原子層堆積) の研究開発を推進しています。
今回、オックスフォード・インストゥルメンツの FlexAL ALD システムを使用し、高品質の成膜を可能にした TU/e の 2 人の博士課程の学生の研究プロジェクトを紹介します。先進的なプラズマ ALD 技術を使って、Karsten Arts 氏は高アスペクト比構造のコンフォーマルデポジションを成功させ、Marc Merkx 氏は窒化チタン (TiN) の高選択的成長を達成しました。
「FlexAL システムの最大のメリットは、プラズマ機能です」
Marc J. M. Merkx - Department of Applied Physics, Eindhoven University of Technology
オックスフォード・インストゥルメンツは、総括的で柔軟、かつ信頼できる、グローバルなお客様サポートをお約束しています。お客様のシステムが稼働している期間、高品質のサービスを提供します。
FlexAL2Dシステムは、ナノデバイス研究開発に向けた 2D 遷移金属ダイカルコゲナイド(TMDC)の ALD を実現し、2D マテリアルの作製に多くのメリットをもたらします。
2D マテリアルの作製
2Dマテリアルに向けた堅牢なALDプロセス
容易な形態制御
ガスポッド - 追加のガスラインを組み込み、柔軟性を高めることが可能
Logviewer ソフトウェア - データログのソフトウェアであり、リアルタイムでグラフ化するとともに、処理後の解析も可能
光学エンドポイント検出器 - 最適なプロセス実績を達成するために重要なツール
X20 コントロールシステム - システムのインテリジェンスを高め、将来の互換性が確保できる、柔軟で信頼性の高いツール
Dual CM ゲージスイッチ - 1つの圧力制御バルブで、2つの異なるレンジのキャパシタンスマノメータを使用することが可能