シリコン深堀リアクティブイオンエッチング (DRIE)、またはシリコン深堀エッチング (DSiE)は、ウェハや基板に深い穴や溝を形成するために用いられる高度な異方性エッチングプロセスで、一般的に高いアスペクト比のプロセスで用いられます。
Estrelas® DSiE システムにより、究極的にフレキシビリティの高いプロセスが実現し、MEMSやアドバンスパッケージング、ナノテクノロジーなどのマーケットに多数のプロセスソリューションが提供されます。
MEMS (Micro Electro-Mechanical System) の製造において深堀エッチングを実現するために使用される二つの技術は、ボッシュプロセスとクライオプロセスです。長年にわたるシステムとプロセスの開発により、この2つの技術は進化してきましたが、それぞれの基本的な部分に変わりはありません:
あらゆるシリコンエッチングデバイスの製造を可能にするために設計されたシリコン深堀エッチングにより、以下が実現されます:

ボッシュプロセスでは、フッ素ベースのプラズマケミストリーを使用してシリコンをエッチングし、フルオロカーボンプラズマプロセスと組み合わせて、側壁パッシベーションとエッチングマスクの選択性を向上さ せます。完全なエッチングプロセスでは、エッチングとデポジションの工程を何度か繰り返し、深く垂直なエッチングプロファイルを実現します。これは、ウェハに到達する前に高密度のプラズマ領域で分解されるソースガスに依存しています。
リアクティブイオンエッチング装置 (RIE) では、イオンとフリーラジカル種のバランスが悪いため、この技術を実行することはできません。このバランスは、高密度プラズマ装置 (HDP) によって実現することができます。最も広く使われているHDPは、誘導結合を利用して高密度プラズマ領域を生成するため、ICP(Inductively Coupled Plasma: 誘導結合プラズマ)と呼ばれます。
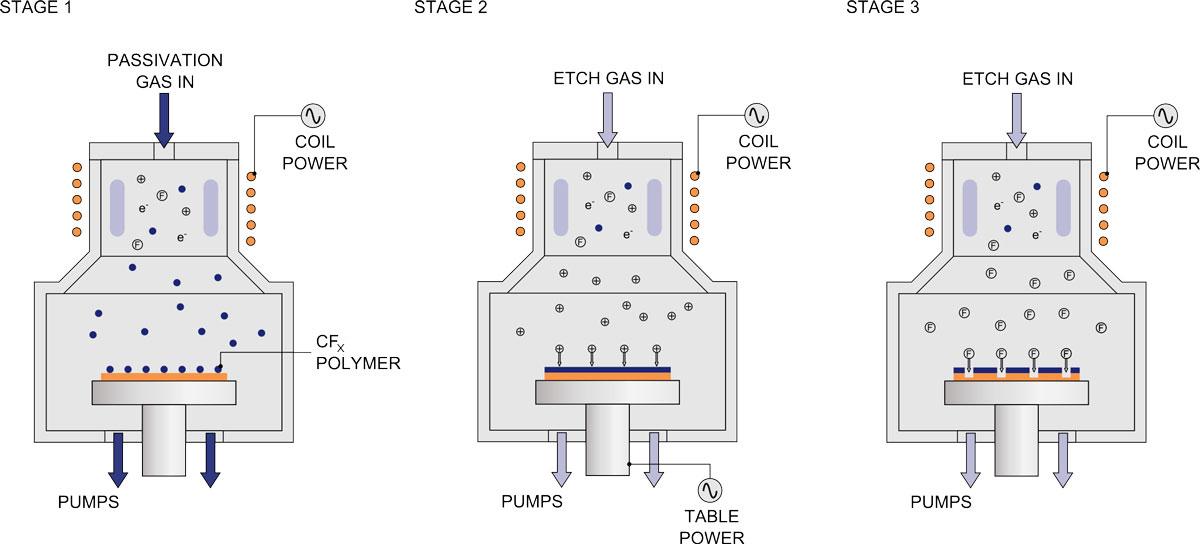
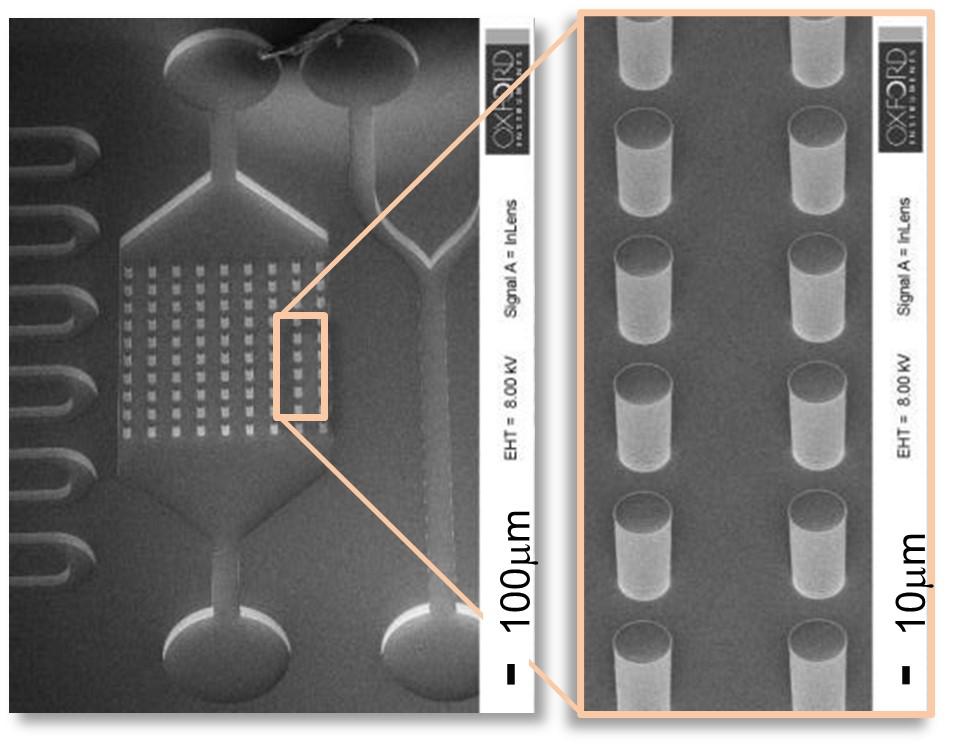
マイクロフルイディクス(深さ200mm)、ビア(深さ400mm以上)など、高レートで制御されたスカロップ
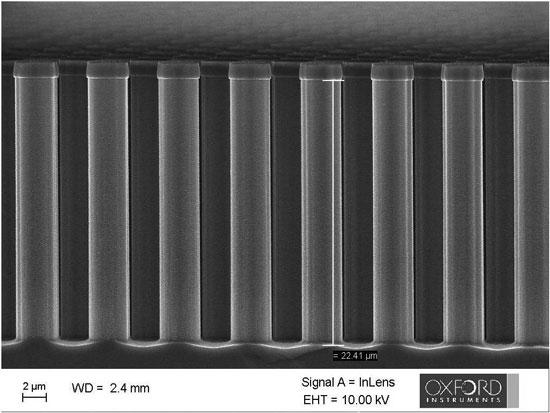
ボッシュプロセスを用いて製造したマイクロニードル
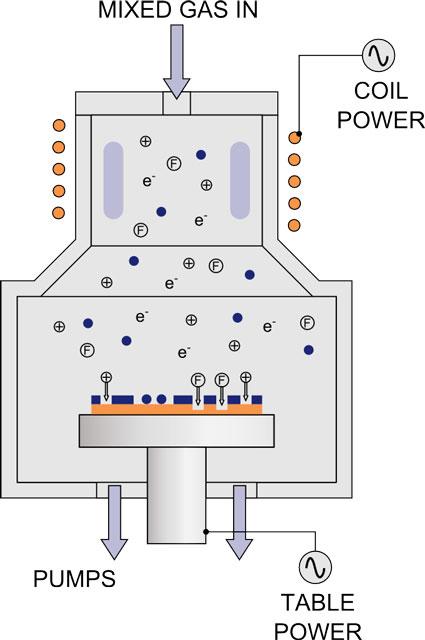
ボッシュプロセスと同様に、この技術も SF6 を使用してシリコンエッチング用のフッ素ラジカルを供給します。シリコンは揮発性のある SiF4 の形で除去されます。
大きな違いは、サイドウォールのパッシベーションとマスク保護のメカニズムにあります。このプロセスでは、フッ素ポリマーを使用するのではなく、サイドウォールに酸化物/フッ化物 (SiOxFy) のブロッキング層 (厚さ約 10~20 nm) を形成します。この層は極低温で形成され、フッ素ラジカルによる下のシリコン層へのダメージを抑制することができます。
また、低温・低バイアス動作は、マスク材料 (通常はフォトレジストまたは SiO2) のエッチングレートを低下させるのに効果があります。

クライオプロセスを用いて作製したマイクロモールド
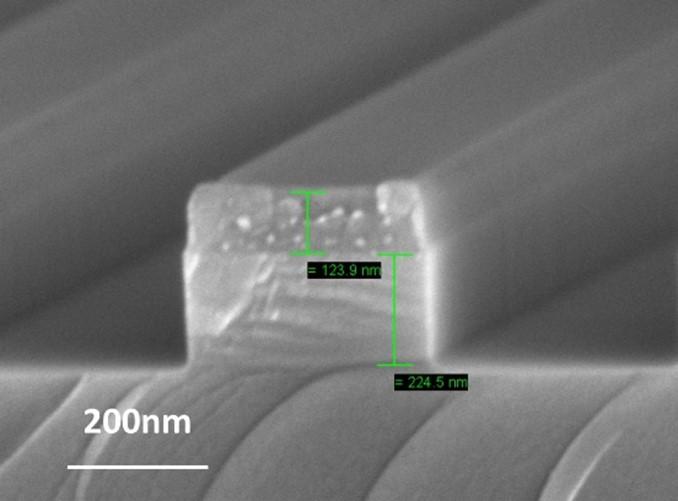
エッチング加工したシリコン導波路
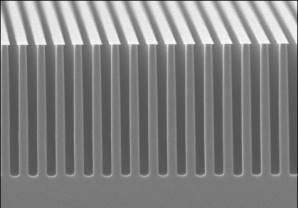
クライオDSEによる平滑サイドウォール(スカロップなし)。
提供:TU Twente
PlasmaPro 100 Estrelas は、MEMSやアドバンスパッケージング、ナノテクノロジーマーケット全体に適用される DSiE (シリコン深堀エッチング) アプリケーションにあらゆる柔軟性をもたらします。
