2026年度オックスフォード・インストゥルメンツの予算申請用カタログが完成しました。目的やご予算に応じた最適な機器をスムーズに比較・検討いただけます。予算の検討・次期設備導入のご検討に、ぜひご活用ください。
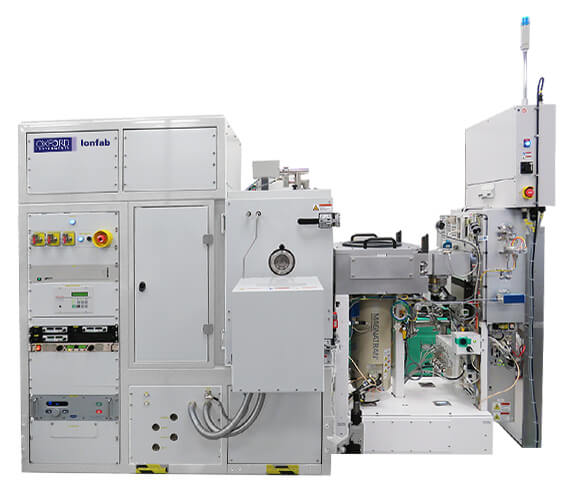
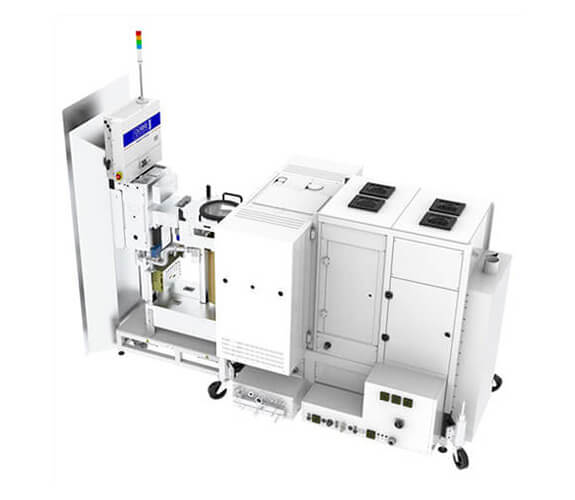
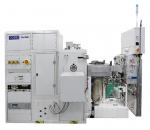
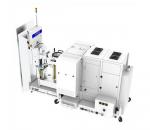
当社のイオンビームエッチング(IBE)および、イオンビームデポジション(IBD)システムは、高品質な材料プロセスにおいて評価の高い装置です。オープンロード、枚葉式ロードロック、カセット式など、柔軟なハードウェアオプションが用意されています。アプリケーションに合わせたシステム仕様で、より速く、より再現性の高いプロセス結果を実現します。
マルチモード機能
他のプラズマエッチング装置や デポジション装置とのクラスタリングが可能
枚葉式ロードロックまたはクラスタ式ウェハ ハンドリング
デュアルビーム仕様
非常に平滑な薄膜が実現
比類ないバッチ均一性とプロセス再現性
正確なエンドポイント検出 - SIMS、発光素子
超低コンタミネーションが実現した高品質薄膜
高スループット、コンパクト、低コストの運用が実現
特許取得の高速基板ホルダー(最大500rpm)
非常に正確なin-situ光学薄膜コントロール
イオンビーム技術により、エッチングとデポジションのための非常に多用途なアプローチが可能になり、単一のツールとして提供されるシステムを最大限に活用することができます。イオンビームエッチングは、優れた均一性とともに、最大限の柔軟性を提供します。
オープンロード、枚葉式ロードロック、カセット式など、柔軟なハードウェアオプションが用意されています。アプリケーションに合わせたシステム仕様で、より速く、より再現性の高いプロセス結果を実現します。
ウェハサイズ |
100 mm |
200 mm | |||||||||
エッチング RF イオンソース |
15 cm |
30 cm | |||||||||
基板回転速度 |
最大 20 rpm | ||||||||||
基板傾斜角 |
水平 - 90°、下向き + 65° | ||||||||||
テーブル温度 |
10 ℃~300 ℃ (チラーやヒーターの構成による) | ||||||||||
IBE 用 Ionfab についての詳細は下記よりご連絡ください
お問い合わせイオンビーム技術により、エッチングとデポジションのための非常に多用途なアプローチが可能になり、単一のツールとして提供されるシステムを最大限に活用することができます。当社のイオンビームデポジション製品は、高品質、高密度、平滑な表面を持つデポジション膜を製造できることから評価されています。
当社のシステムは、オープンロード、枚葉式ロードロック、カセット式などの柔軟なハードウェアオプションを備えています。アプリケーションに合わせたシステム仕様で、より速く、より再現性の高いプロセス結果を実現します。
ウェハサイズ |
100 mm |
200 mm | |||||||||
デポジション イオンソース |
15 cm |
15 cm | |||||||||
基板回転速度 |
最大 20 rpm | ||||||||||
基板傾斜角 |
水平 - 90°、下向き + 65° | ||||||||||
テーブル温度 |
10 ℃~300 ℃ (チラーやヒーターの構成による) | ||||||||||
IBD 用 Ionfab についての詳細は下記よりご連絡ください
お問い合わせ高いフレキシビリティが要求される研究・パイロット生産に対応したコンパクトなイオンビームエッチング・デポジションシステムで、エッチングまたはデポジション用に最大2個(15cm)のイオンソースを搭載しています。最大200mmウェハサイズでのデポジション、最大100mmウェハサイズでのエッチプロセスに最適化されています。
本装置は、設置面積は同じですが、プロセスチャンバーが大きく、エッチングとデポジションの両方で最大200 mmまでのウェハプロセスができるように設計されています。30cmのエッチングイオンソースを搭載し、優れたエッチング均一性と優れたプロセス安定性を実現し、パイロットおよびフルスケール製造に最適なシステムとなっています。
オックスフォード・インストゥルメンツは、総括的で柔軟な信頼できる、グローバルなお客様サポートをお約束しています。お客様のシステムが稼働している期間、高品質のサービスを提供します。