原子層堆積(ALD: Atomic Layer Deposition)は先端的なデポジション (成膜) 技術であり、数 nm の超薄膜を正確に制御された手法により堆積させることが可能です。また、優れた膜厚制御と均質性を実現するばかりでなく、アスペクト比の高い構造に対して形状に沿った成膜によって 3D 構造を作製することができます。
ALD は自己制限的な表面反応を利用するため、ピンホールや異粒子が非常に少ない成膜が可能となります。このことは様々な用途に対して大きなメリットとなります。現在、デバイス構造が微細化する中、薄膜と界面の制御や薄膜のクオリティは、多様な用途において高いレベルで実現しています。さらにプラズマの活用により、多くのマテリアルの薄膜特性と制御性向上が可能となっています。ALDにより、様々な表面の予備処理にフレキシブルに対応し、ダメージの少ない成膜プロセスが実現しています。
原子層堆積は、通常、4ステップのサイクルから構成され、要求されるデポジション厚さを得るために必要な回数が繰り返されます。Al(CH3)、(TMA)、O2 プラズマを用いた Al2O3 の ALD の例を、以下に示します。
ステップ 1) 基板にTMA原料プリカーサー蒸気を投入する。TMAは、表面に吸収されて反応を生じる。プリカーサーと条件を正しく選定すれば、反応は自己制限的になる。
ステップ 2) 全ての残存原料プリカーサーおよび反応生成物を排出する。
ステップ 3) 反応性酸素ラジカルを用い、低損傷リモートプラズマで表面を照射することにより、表面が酸化され表面配位子が除去される。表面配位子の個数が制限されるので、この反応は自己制限的になる。
ステップ 4) 反応生成物が、チェンバーから排出される。
ステップ 3 )だけが、H2Oによる熱プラズマかO2プラズマで変わります。ALDプロセスは、1サイクルあたりオングストローム(またはそれ以下)スケールの厚さを堆積するので、デポジションプロセスは、原子スケールで制御されます。

前半サイクル

排出

後半サイクル
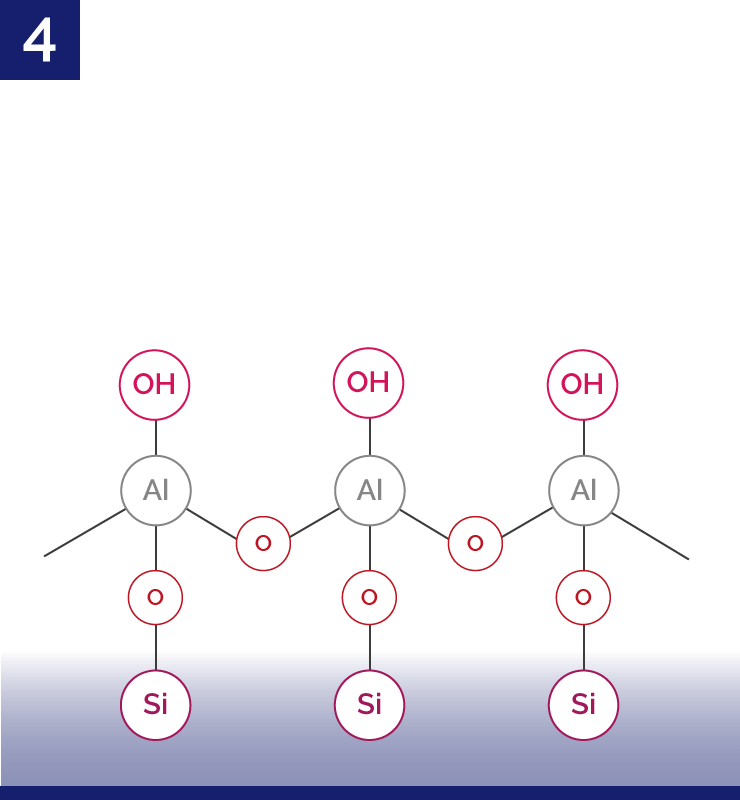
排出
サーマルALDの利点に加えて、PEALDは向上した膜質を持つ前駆体化学のより広い選択を可能にします:
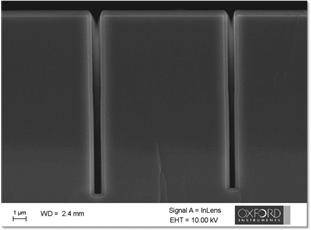
高アスペクト比(15:1)形状に対する高速プラズマALDを用いたSiO2コンフォーマルコーティング
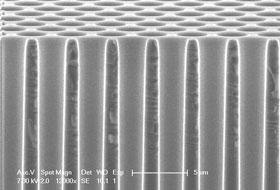
FlexAL ALDを用いた Al2O3 デポジション - 提供アイントホーフェン工科大学
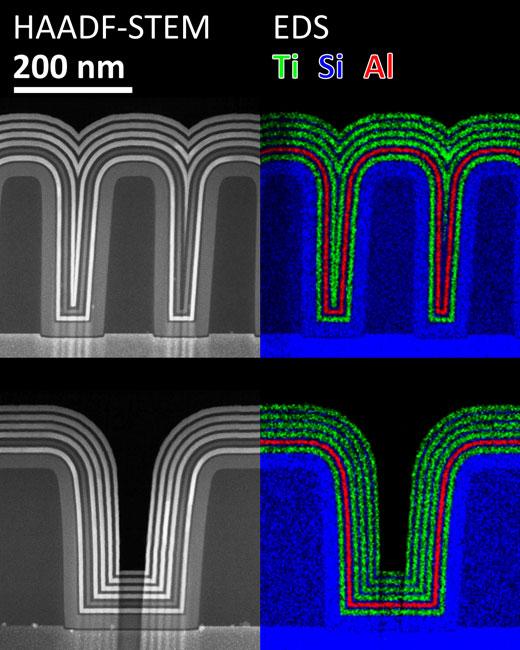
プラズマALDを用いたSiO2、 TiO2、Al2O3 のコンフォーマルデポジション (CC BY 4.0 license), image library at www.AtomicLimits.com, 2021

| PlasmaPro ASP | FlexAL |
Atomfab | |
| ローディング | ロードロックまたはカセットハンドラー | ロードロックまたはカセット式 | カセットハンドリング アライナー付きBrooks MMX 冷却ステーション (オプション) |
| 基板 | 最大 200mm ウェハのハンドリングとキャリアプレートへの設置 | 最大 200mm ウェハのハンドリングとキャリアプレートへの設置 | 200mm、150mm、100mmに対応可能 |
| 蒸気化、固体プリカーサ | 最大6本 バブラーまたはベーパー引き込み | 最大8本+水、オゾン、ガス | プリカーサ蒸気引き込み |
| 最高プリカーサソース温度 | 200ºC | 200ºC | 室温以下に冷却された高蒸気圧のプリカーサーは、制御された再現性のある注入が可能です |
| MFC制御ガスライン (ラピッドデリバリーシステム搭載); 1) サーマルガスプリカーサ (NH<sub>3</sub>, O<sub>2</sub>など) 2) プラズマガス (O<sub>2</sub>, N<sub>2</sub>, H<sub>2</sub>など) | 4ラインガスポッド(毒性ラインと無毒性ラインで構成可能)さらに Ar (固定)1ライン | 外付けガスポッドに最大10個まで搭載可能 | 4ラインガスポッド(毒性ラインと無毒性ラインで構成可能)さらに Ar (固定)1ライン |
当社のALD装置は、10年以上の経験に基づいて構築されています。以下にオックスフォード・インストゥルメンツのシステムの主な特長を示します。
原子層堆積は広範な材料に対応可能であり、当社のプロセス技術者により、広範なプロセスを設定し確立することができます。革新的なプロセスについて、当社のさまざまなプロセス・ノウハウおよび広大なネットワークは、スタートポイントにおいて非常に良い足がかりになるアイデアを提供でき、堅牢なプロセスを迅速に実現することができます。
当社のプラズマに関するノウハウや、危険なガスを含めたMFC制御された混合ガスの取り扱いを活用することにより、プラズマベースのプロセスが実現できます。

ALDにより2D 材料 も成膜することができ、高品質MoS2薄膜を目標にした開発が新しく進んでいます。優れた特性を持つ2D硫化物を用いたALDの化学組成制御により、CMOSに適合する温度で、大面積ウェハ(200mm)において膜厚を正確にデジタル制御できる技術が実現しています。
金属 |
フッ化物 |
硫化物 |
Pt |
AlF<sub>3 |
MoS<sub>2 |
Ru |
MgF<sub>2 |
酸化物 |
窒化物 |
Al<sub>2</sub>O<sub>3 |
AlN |
Co<sub>3</sub>O<sub>4 |
|
Ga<sub>2</sub>O<sub>3 |
GaN |
HfO<sub>2 |
HfN |
In<sub>2</sub>O<sub>3 |
|
Li<sub>2</sub>CO<sub>3 |
|
MoO<sub>3 |
|
Nb<sub>2</sub>O<sub>5 |
|
NiO |
|
SiO<sub>2 |
Si<sub>3</sub>N<sub>4 |
SnO<sub>2 |
|
Ta<sub>2</sub>O<sub>5 |
TaN |
TiO<sub>2 |
TiN |
WO<sub>3 |
WN |
ZnO |
|
ZrO2 |
アイントホーフェン工科大学(TU/e)の2名の博士課程学生の研究プロジェクトを紹介します。TU/eは、エンジニアリングサイエンスとテクノロジーをリードする大学として、原子レベルの膜厚制御で超薄膜を成膜できる高度な成膜技術である原子層堆積(ALD)の産業応用を進めるために、革新的なプロセス技術に取り組んでいます。
当社のプラズマテクノロジーとアイントホーフェン工科大学は、15年にわたるパートナーシップのもと、ナノ加工技術の多くのアプリケーションにおいて、最も急速に発展している技術の1つであるALDの研究開発を推進しています。研究生であるKarsten ArtsとMarc Merkxは、リモート誘導結合プラズマ源を特徴とするオックスフォード・インストゥルメンツのFlexAL ALDシステムを使用しており、高品質の成膜を実現しています。
Atomfabは、GaN HEMTおよびRFデバイス製造用に特別に設計された、業界最速レベルの量産向けリモートプラズマALD装置です。