プラズマエッチングは、私たちが日常的に利用している多くのテクノロジーを支えている、現代に欠かせないツールだと言えます。例えば、スマートフォンはプラズマエッチングの技術なしには実現し得なかったと言っても過言ではありません。プラズマエッチングは、広範な材料に対して、nm スケールから 数 100 μm スケールの微細構造を形成することができる技術です。
チャンバー内にエッチングしたい材料と反応するガスにRFを加えることでガスをプラズマ化し、さらに反応性を高くしたガスを材料表面で反応させ、表面のエッチングを行います。また、低温でも反応性を高くすることができるため、試料を高温にせず熱応力を少なくするメリットもあります。
プラズマエッチングの先端技術の1つが、ICP-RIEです。プロセス特性として、多くの利点があります。
プロファイル制御を取り上げ、そのメリットを解説します: ムーアの法則により、デバイスの寸法精度(CD)は µm レベル以下にまで低下しています。垂直方向と水平方向が同じ方向にエッチングされる形状を持つ場合、このような密に詰め込まれたデバイスのアレイでは、すぐに互いに干渉してしまいます。
ICP-RIE プラズマエッチングは、完全に垂直な形状を作り出すことができるため、CD は維持されます。ICP-RIE プラズマエッチングは、ウェットエッチングと比較して、このような理由から広く使用されています。
さらに詳しく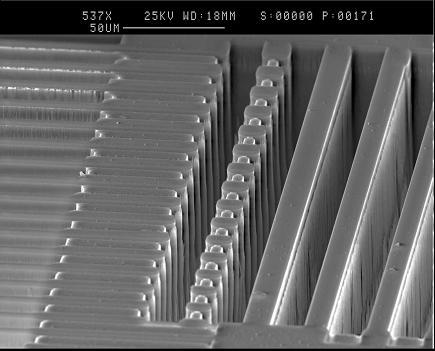
ICP RIEを用いたシリコン深堀りエッチング

ガリウム-ヒ素基垂直共振器面発光レーザーVCSELのエッチングプロセス
RIEによるプラズマエッチングは、何十年も広く用いられています。その性能は ICP-RIE に及びませんが、多くのアプリケーションに対応する、シンプルかつ非常に有効的な技術です。
例えば、絶縁体マスクのプラズマエッチングでは、通常、高エッチングレートを必要とせず、RIE により優れたマスクを作製するのに十分な垂直性が得られています。
さらに詳しく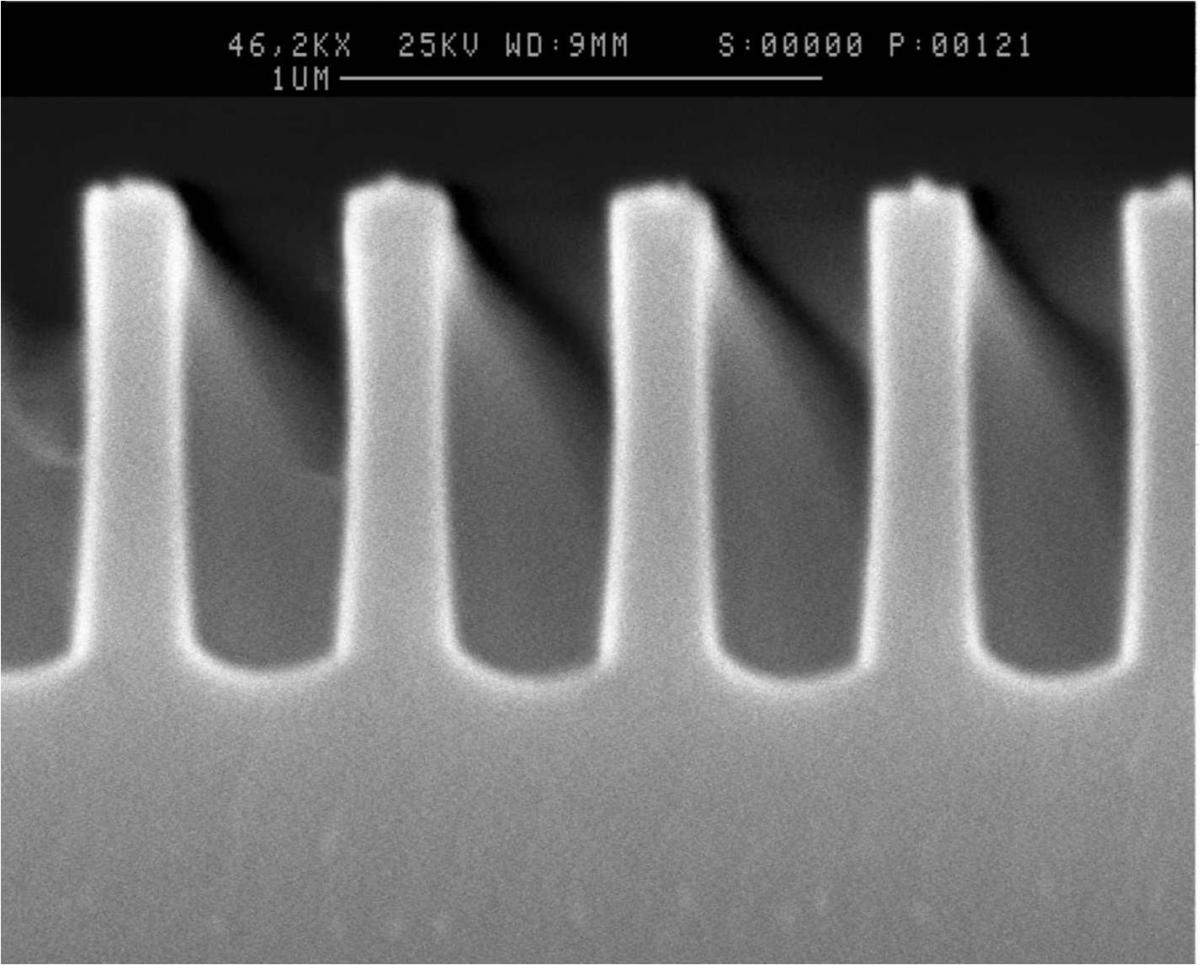
SiO2 のRIEエッチング
PEエッチングは、プラズマエッチングソリューションの中で、最も指向性が低いため、微細で垂直な形状を作り込むには不向きです。アンダーカットが許容される、高選択的等方性プロセスに使用され下層に選択的に大面積の材料をクリアするのに有用です。
プラズマエッチングは、広範なデバイスの作成に使用される、高度で汎用性の高い技術です。
さらに詳しく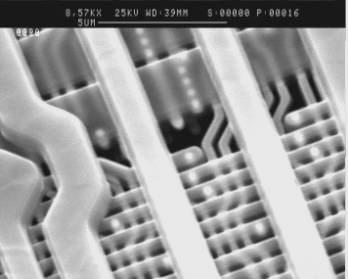
PEエッチングを用いた故障解析