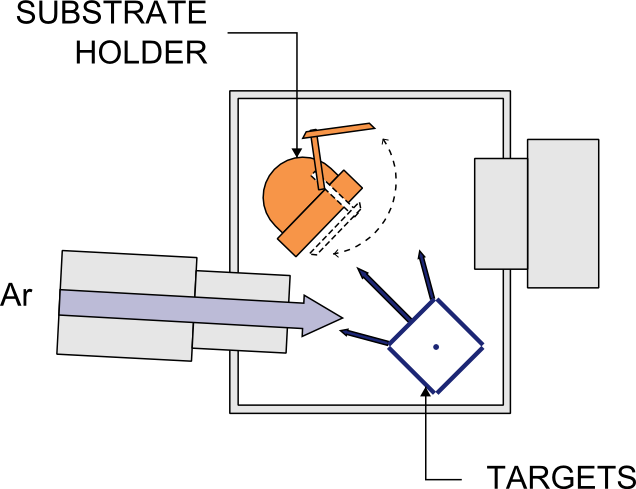
| Ionfab | |
| デポジションイオン源 | 150 mm |
| デポジション エリア | < 200 mm |
| ターゲット数 | 4 個まで可能 |
| 基板ホルダサイズ | 8 インチまで可能 |
| 表面検出 | デュアル Xtal または WLOM (白色光学モニター) |
| 基板ホルダ回転数 | < 500 rpm |
| 基板ホルダ傾斜角度 | イオンビームと基板表面の法線の間において0° ~ 75° |
| 基板ホルダ加熱 | < 300 ºC (組み込みヒーター) |
| 基板ホルダ冷却 | 基板冷却用 He または Ar バックサイドガスによる液体クーラント 5℃~60℃(最大 50 Torr) |
| アシストまたはプレクリーンソース | 150 mm および 300 mm RF イオン源 |
高エネルギーイオンビームがターゲットに衝突して材料を飛散させ、それによって材料のプルームを形成し、試料の表面に堆積させます。イオンビームにより堆積された薄膜の屈折率、吸収、散乱、接着、充填密度などの特性は、ビームフラックスやエネルギ、入射材料に対する基板の角度、ガスフローなどのビームパラメータを変えることにより、細かく調整することが可能になっています。
イオンビームデポジション (IBD) は、イオンビームスパッタリングによる薄膜の成膜方法の 3 つ (IBD、RIBD、IBAD) のうちの 1 つになります。
RIBD (リアクティブイオンビームデポジション): 成膜中にN2やO2などの反応性ガスをチャンバー内に注入し、酸化物や窒化物の化学量論的な調整を行います。
IBAD (イオンビームアシストデポジション): アシストイオン源は、デポジションイオン源と組み合わせて、成長中の膜の特性を調整するために使用することもできます。また、成膜前のプリクリーニングに使用することで、密着性を高めることも可能です。
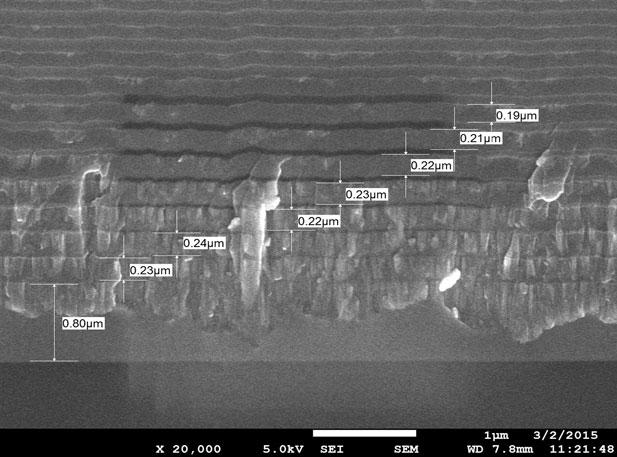
IBDを用いて作製した32層GRIN (屈折率分布型)レンズ
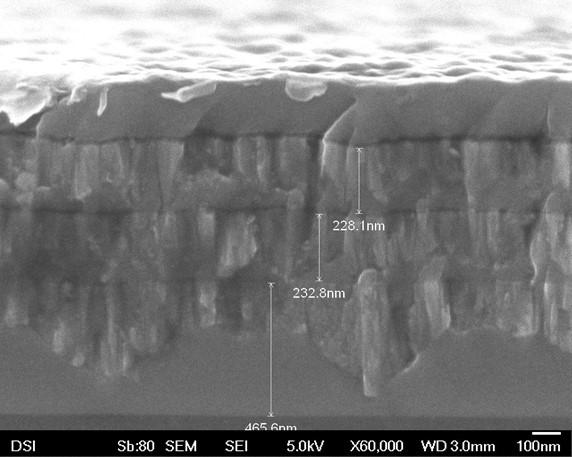
IBDを用いて作製した 7 層 GRIN (屈折率分布型) 構造
イオンビームエッチングとデポジション装置です。標準チャンバーと大型チャンバーの2種類のチャンバーがあり、最大200mmまでのウェハにIBD処理を行うことができます。