PECVD は様々な材料の薄膜のデポジションを行う確立された技術です。多くのデバイスにおいて、高品質のパッシベーション層や高密度のマスクを作製する目的で、PECVDが必要とされています。
当社のプラズマCVDシステムでは、屈折率、応力、電気特性などの膜特性や、ウェットエッチング速度などを制御することにより優れた膜均一性や高い成膜速度が実現するよう特別な設計がされています。エンドポイント制御を備えた当社のプラズマクリーニングプロセスは、物理的または化学的チャンバー内洗浄の必要性を大幅に軽減します。
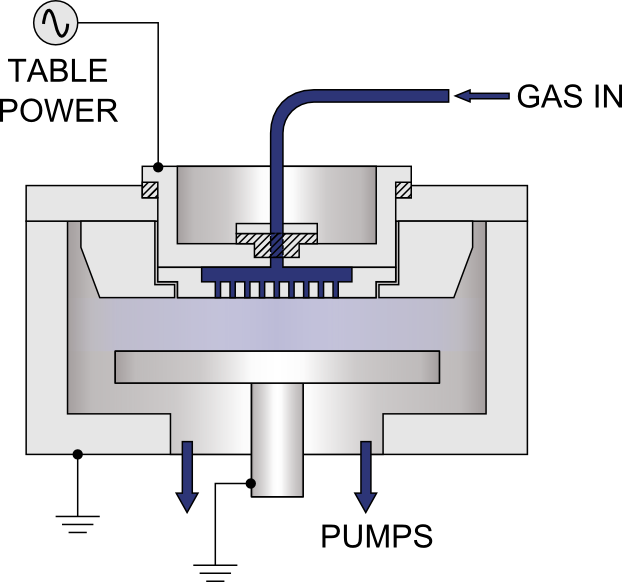
| PlasmaPro 80 | PlasmaPro 100 | PlasmaPro 800 | |
| 電極サイズ | 240 mm | 240 mm | 460 mm |
| 基板 | 最大 240 mm (マルチウェハまたはスモールピース) | 最大 200 mm (マルチウェハまたはスモールピース対応キャリアオプション) | 最大 460 mm (マルチウェハまたはスモールピース) |
| ドーパント | No | PH3, 3B2 H6, GeH4 などのさまざまなドーパントが利用可能 | No |
| 液体プリカーサー | No | Yes (TEOS) | No |
| MFC 制御ガスライン | 4ライン、8ラインまたは12ラインのガスボックスが利用可能 | ||
| 応力制御用 RF スイッチ | Yes | ||
| ウェハテーブル温度範囲 | 20°C ~ 400°C | 標準 20°C ~ 400°C (オプション 最大 1200°C) | 20°C ~ 400°C |
| in-situ プラズマクリーニング | Yes 最適なクリーニング時間を確保するためのエンドポイントが利用可能 | ||