リアクティブイオンエッチング(RIE)は、一般的なプラズマエッチングとして、簡単に操作できるとともに、経済的なソリューションです。単一のRFプラズマ源により、イオンの密度とエネルギーを設定することができます。
当社プラズマテクノロジーのRIEモジュールにより、様々なプロセスに異方性ドライエッチングを適用することが可能になります。
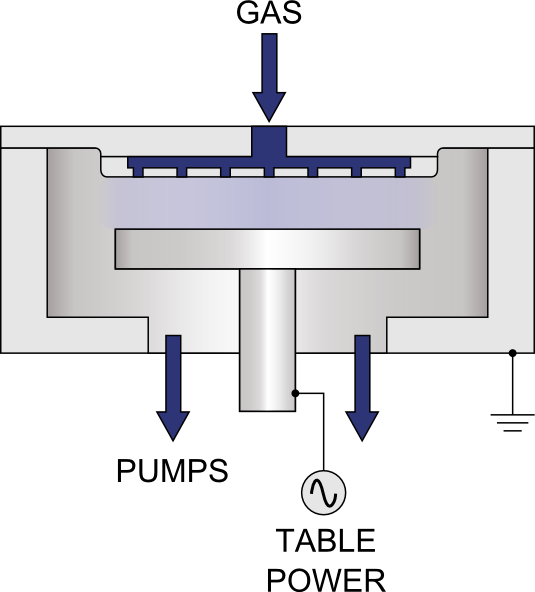
エッチングプロセスの選択肢:
RIE の特長:
様々な材料のエッチングが可能:
| PlasmaPro 80 |
PlasmaPro 800 |
PlasmaPro 100 | ||
| 電極サイズ | 240mm | 460mm | 240mm | |
| ローディング | オープン |
ロードロックまたはカセット式 | ||
| 基板 | 最大 240mm |
最大 460mm |
200mm (マルチウェハまたはスモールピース対応キャリアオプション) | |
| MFC制御ガスライン | 8ラインまたは12ラインのガスボックスが利用可能 | |||
| ウェハテーブル温度範囲 | -150°C ~ 400°C |
10°C ~ 80°C | -150°C ~ 400°C | |
| He 裏面冷却オプション | Yes | No | Yes | |
| ICP オプション | Yes | No | Yes | |
| 集束プラズマ | Yes | No | ||
当社は、ロンドン大学 (UCL) の、Oscar Kennedy博士 (UCLQ ポスドク研究員) とWing Ng (上級研究員) に最新の研究プロジェクトと当社のPlasmaPro® 80 RIE システムの使用方法についての感想をお聞きする機会がありました。
Oscar Kennedy 博士は、PlasmaPro RIE システムを使用して超電導 NbN 膜をエッチングして超電導回路を作成しましています。また、Wing Ng 博士は、RIE システムを使用し、一対のチップベースの光バッファ用導波路間に、平滑な側壁の50 nm のギャップを正確にパターン化しました。 詳細については、導入事例をご覧ください。