イオンビームエッチング(または不活性ガスによるミリング)は、高真空チャンバー内において適切にパターニングされたマスクを用いて、荷電粒子(イオン)ビームを基板に照射することにより実現されます。イオンビームは、中和器からの電子によって空間電荷が中和されるため、エッチングさ れる側壁プロファイルを制御し、基板の径方向の均一性の最適化、ナノパターニング中のフィーチャーの形成を、軸対称性を保つために回転しながらビームに対する 傾斜角を用いて行うことができます。
一方、基板を傾けることにより、イオンビームの照射方向を変えることができるため、角度のある形状を形成することができます。両者とも、反応性ガスを用いた化学プロセス(RIBE、CAIBE)により、エッチング速度とマスクへの選択性を向上させることが可能です。
Ionfab® システムの優れた均一性と高い柔軟性により、迅速なプロセス開発と再現性のあるプロセス結果が実現します。
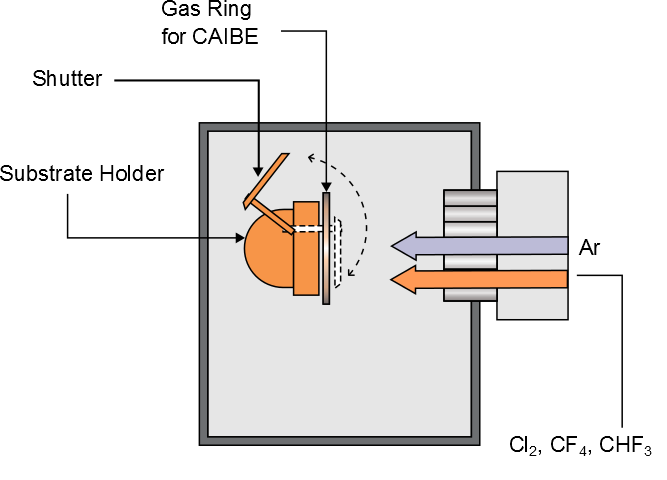
| Ionfab | |
| エッチングイオン源 | 150 mm または 300 mm (それぞれ最大 4 インチ、8 インチまで対応) |
| エッチングエリア | 最大直径 200 mm または 150 mm の正方形 |
| 基板回転速度 | 最大 20 rpm |
| 基板傾斜角度 | 0º~75º (ビームと基板表面の垂直法線方向の間) |
| 基板加熱 | 最大 300℃ までのヒーター内蔵 (PID 制御) |
| 基板冷却 | 基板冷却用 He または Ar バックサイドガス(最大 50 Torr)付き 5ºC~60ºCの液体クーラント |
イオンビームエッチングには、不活性イオンを用いた物理的なエッチングやミリングプロセスと、反応性イオン種を用いた RIBE/CAIBE による化学/反応成分による材料のエッチングレート差や選択性の向上という 2 通りの方法があります。
リアクティブイオンビーム エッチング (RIBE) およびケミカルアシスト イオンビーム エッチング (CAIBE) モードでは、反応種 (CHF3, SF6, N2, O2 等) をソース (RIBE) またはガスリング (CAIBE) に供給してエッチング生成物とマスク材料の選択性を向上させることが可能です。

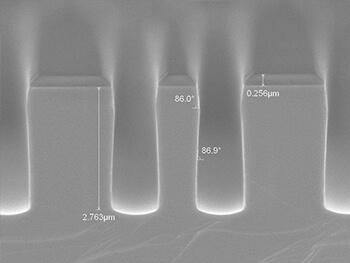
Ionfab では、単一ウェハ用ロードロック室 (真空予備室)、カセット交換式操作など、柔軟なハードウェアオプションを用意しています。また、マルチモード機能により、省スペースで高いスループットを実現します。