原子層エッチング(ALE : Atomic Layer Etching)は先端的なエッチング技術であり、浅い形状での深さ制御に優れています。デバイス形状の小型化に従い、性能アップに必要な精度を実現するために、ますます ALE が注目され、また必要となっています。
今日の先端的マイクロエレクトロニクス・デバイスの製造では、高精度のパターン転写(エッチング)が重要になっています。10 nm 以下の微細化が進み、極薄の 2D材料を使用した革新的デバイスの開発が進むに従い、当然のごとく原子スケールの高精度が必要になっています。
この結果、従来の(連続的)エッチングの限界を超えることのできる、原子スケールでの ALE として知られる技術に、注目が集まるようになりました。プラズマベースの ALE は、ガス注入とイオン照射を繰り返すエッチングプロセスであり、材料を原子層ごとに除去するためで、損傷を非常に少なく抑えて単原子層を除去する能力を持っています。
原子層エッチングは、通常、4ステップのサイクルから構成され、要求されるエッチング厚さを得るために必要な回数が繰り返されます。Cl2/Arを用いたSiのALEの例を、次に示します。
ステップ 1) 基板にエッチングガスを投入する。ガスは、表面を吸収してエッチング材料と反応する。エッチングガスは、しばしばプラズマ解離されて、吸収速度を増大する。注入ガスと条件の正しい選定により、単原子層が吸収された後、化学注入が停止すれば、反応は自己制限的になる。
ステップ 2) 全ての残存注入ガスを排出する。
ステップ 3) 低エネルギーの不活性イオンにより、表面を照射することによって、反応表面層が除去される。イオンのエネルギーが、化学的に変化した表面層を除去するに充分である一方、下層のバルク材料をエッチング(スパッター)するには小さければ、この反応は自己制限的になる。
ステップ 4) エッチング生成物が、チェンバーから排出される。

原子層エッチングは、GaN ベースの HEMT の品質を改善し、高いエッチング速度に関連する損傷を根絶することを約束する。
化合物半導体誌のMike Cooke博士とAndy Goodyear博士によって書かれました。

ALDによる Si トレンチ (深さ 110 nm、幅 25 nm)。HSQマスクは除去されていない。

MoS2 に対する ALE 後、ラマンによる欠陥のスペクトルが示されていない。ALE が低ダメージのエッチング性能を有していることがわかる。
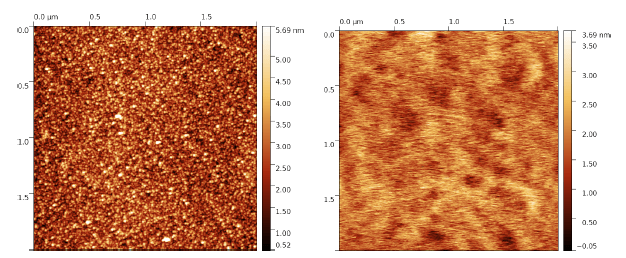
200 サイクルの ALE 後に得られた AlGaN 表面の粗さ。AFM により測定。左=エッチング前(Ra=600pm)、右=エッチング後(Ra=300pm)。ALE により表面が平滑化されていることがわかる。
ALEは、Si、a-Si、MoS2、SiO2、GaN、AlGaN、III-V化合物、Si3N4、グラフェン、HfO2、ZrO2、Al2O3を含めた、広範な材料に適用できます。
エッチングされる材料 |
注入ガス |
エッチングガス |
MoS<sub>2 |
Cl<sub>2 |
Ar |
Si or a-Si |
Cl<sub>2 |
Ar |
SiO<sub>2 |
CHF<sub>3</sub> or C<sub>4</sub>F<sub>8 |
Ar or O<sub>2 |
AlGaN or GaN |
Cl<sub>2</sub>, BCl<sub>3 |
Ar |
AlGaN or GaN |
N<sub>2</sub>O |
BCl<sub>3 |
GaAs or AlGaAs |
Cl<sub>2</sub>, BCl<sub>3 |
Ar |
InP or InGaAsP etc. |
CH<sub>4</sub>, Cl<sub>2 |
Ar |
SiN |
H<sub>2 |
Ar |
Al<sub>2</sub>O<sub>3 |
BCl<sub>3 |
Ar |
Graphene |
O<sub>2 |
Ar |
HfO<sub>2</sub>, ZrO<sub>2 |
Cl<sub>2</sub>, BCl<sub>3 |
Ar |

AlGaN のALEプロセスサイクル
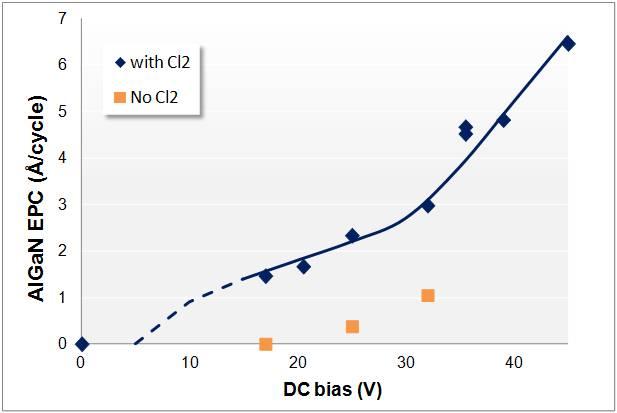
塩素の有無による、サイクルあたりのAlGaNのエッチング
当社の原子層エッチング装置は、13年以上のALDの経験に基づいて開発されました。主な特長は、以下のとおりです。